7MEMS之表面牺牲层标准工艺
虽然硅基MEMS制造工艺起源于半导体工艺,但由于MEMS技术尚处于发展阶段,且具有多学科交叉的特点,所研制的微器件结构、功能和原理差异显著。在以上的文章中,我们主要介绍了MEMS的制造工艺,而制备MEMS器件往往需要将多种工艺结合,形成了两个标准工艺:表面牺牲层标准工艺、体加工标准工艺,下面介绍表面牺牲层的标准工艺:
在表面牺牲层工艺中,可动的机械结构通常是由悬置在衬底上多晶硅层形成的,而牺牲层则被用来分隔多晶硅层和衬底,当加工完毕之后,牺牲层被腐蚀掉,去除牺牲层的过程叫做释放。以制备平面静电马达为例,其制备按照表面牺牲层的标准工艺如下:
1.首先对(100)n型硅进行磷掺杂,以提高衬底的导电性,防止静电器件表面的电荷积聚;然后使用LPCVD工艺沉积一层600nm的低应力氮化硅作为绝缘层;
2.采用LPCVD工艺沉积500nm的多晶硅,然后通过光刻及反应离子进行图形化;(图1)
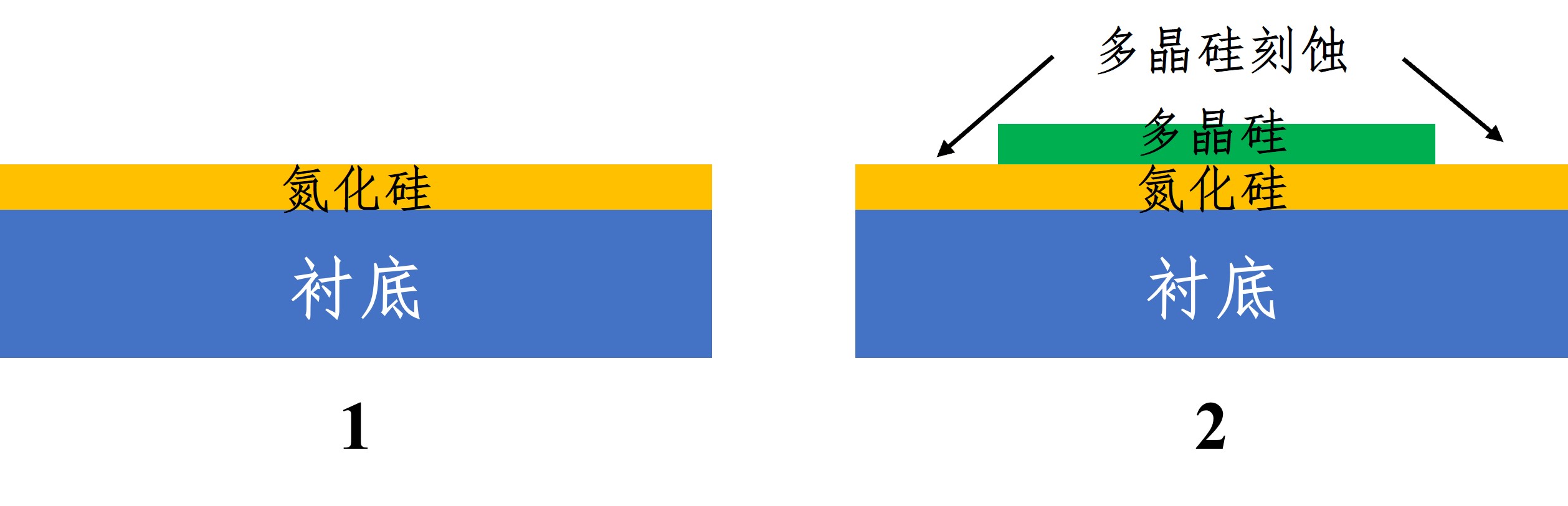
图1.步骤1和2流程图
3. 使用LPCVD沉积2μm的磷硅玻璃(主要成分SiO2)作为牺牲层,并在1050℃下退火1小时降低应力,然后通过BOE湿法腐蚀在其表面形成750nm凹槽;再进行1次光刻和反应离子刻蚀,形成连接孔,以实现后续与上层多晶硅的连接;
4.使用LPCVD沉积2μm多晶硅,主要用于形成转子和部分定子结构。再在其表面沉积200nm的磷硅玻璃,并1050℃退火1小时,目的是降低应力并且利用扩散增加多晶硅的导电性;(图2)

图2.步骤3和4流程图
5.对第4步制备的多晶硅和磷硅玻璃进行光刻和反应离子刻蚀,其中,图形化后的磷硅玻璃可以与光刻胶一起作为刻蚀掩膜,更好的保护不被去除的多晶硅。
6.使用LPCVD工艺沉积750nm的磷硅玻璃作为牺牲层,并进行退火降低应力。(图3)
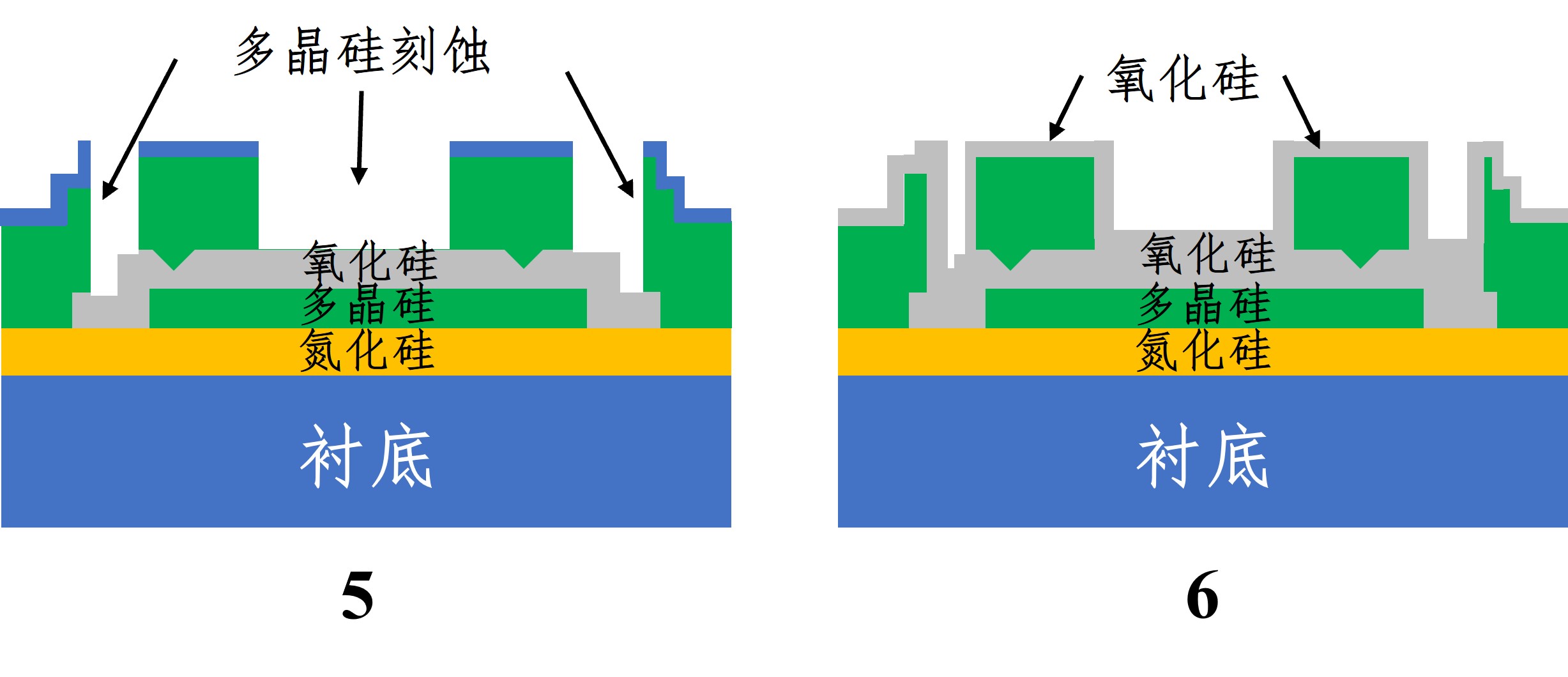
图3.步骤5和6流程图
7.对第6步制备的磷硅玻璃进行光刻和反应离子刻蚀,以实现后续第4步的多晶硅层与上层多晶硅的连接,再将以上制备的磷硅玻璃层进行刻穿,实现底层多晶硅与最上层多晶硅的连接;
8.再使用LPCVD沉积1.5微米的多晶硅,主要用于形成转轴和部分定子结构,再沉积磷硅玻璃并退火,与上述目的相同;(图4)
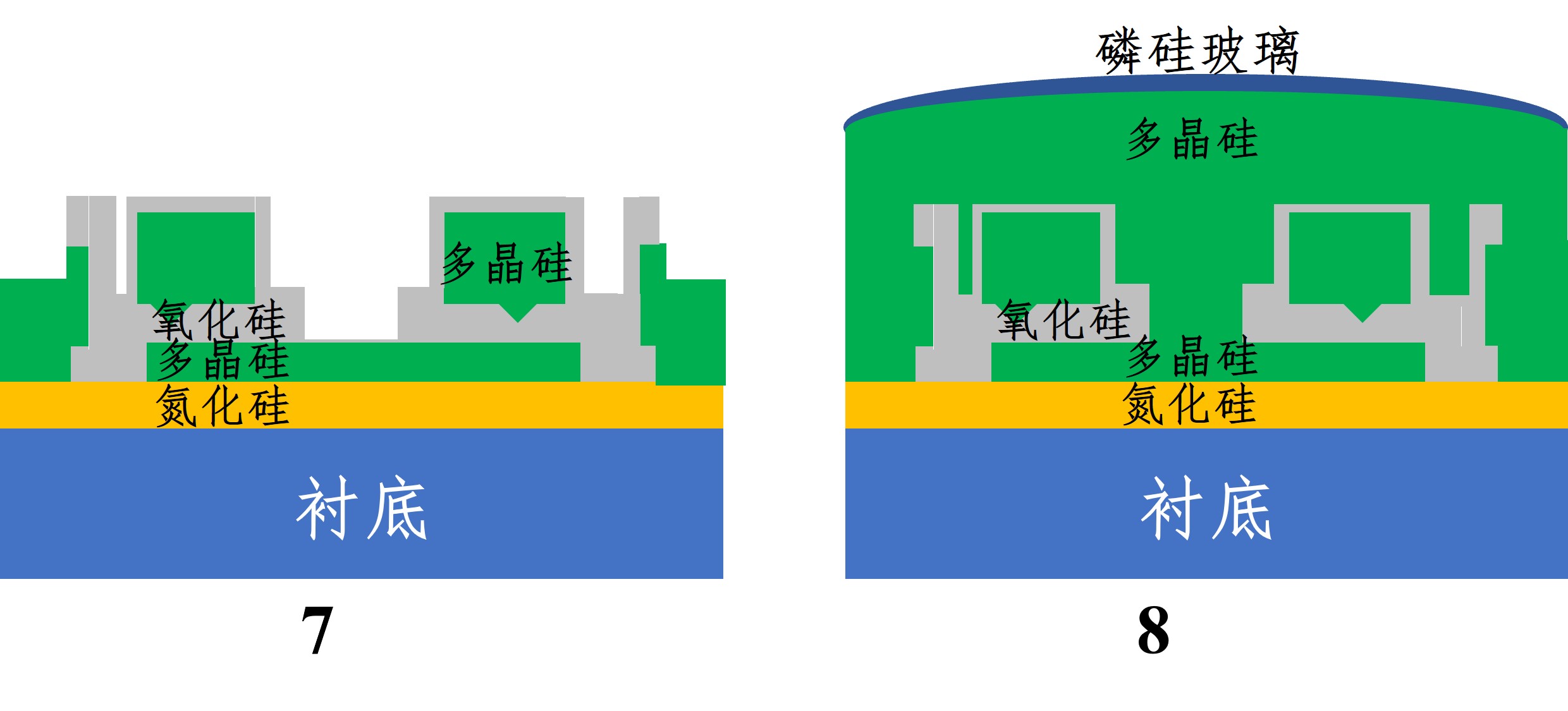
图4.步骤7和8流程图
9.对最上层的多晶硅进行光刻和反应离子刻蚀,进行图形化;
10. 使用METAL光刻板光刻,然后采用剥离工艺制备500nm的金属层作为焊盘或连接线;
11.采用49%氢氟酸腐蚀牺牲层1.5-2min,实现整个马达的释放,制备电动马达。(图5)
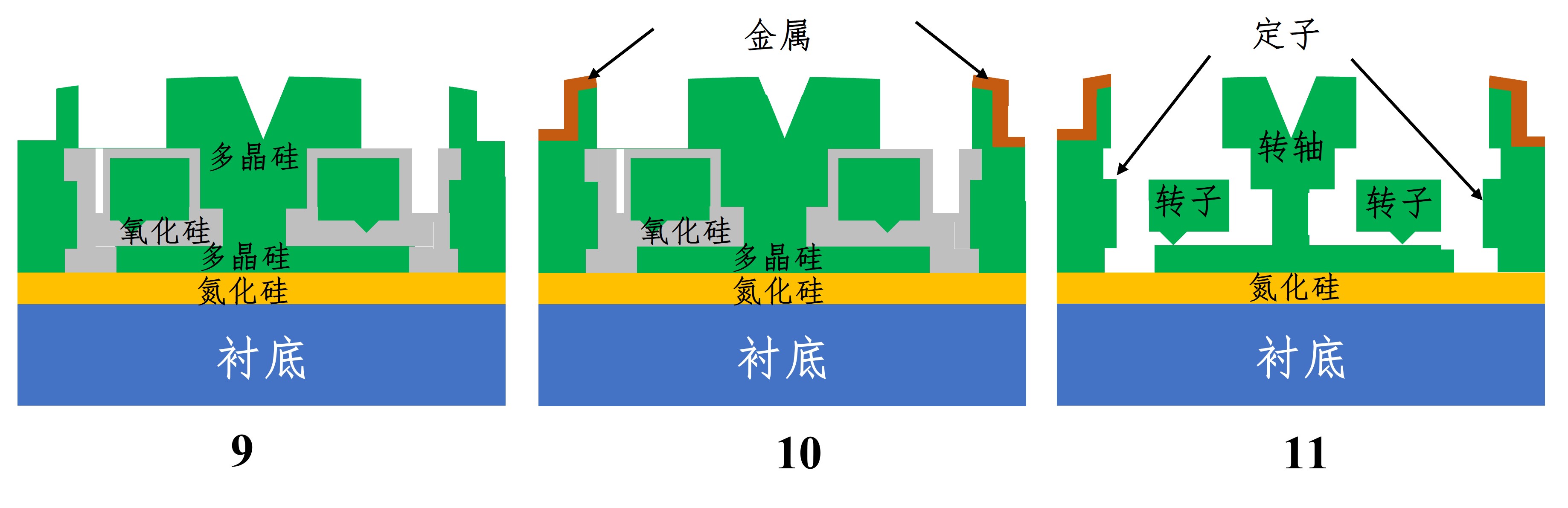
图5.步骤9、10和11流程图
摘要:
MEMS器件制造中需要整合各种加工方式,因此形成了两种标准工艺,一是表面牺牲层标准工艺,二是体加工标准工艺,本文章将通过介绍表面牺牲层标准工艺以理解各加工工艺的整合。

 服务热线:
服务热线:
