MEMS之薄膜制备
在MEMS工艺中,薄膜的制备在设计和每一步的工艺中都是至关重要的,沉积薄膜的密度、晶型、杨氏模量以及加工后的残余应力都会影响器件的性能,甚至使器件失效。本文章主要针对MEMS中常见的薄膜制备方法进行介绍,主要有化学气相沉积、金属镀膜、SOI硅片的制备:
化学气相沉积是通过化学反应的方式,利用加热、等离子激励或光腐蚀等各种能源,在腔体内使气态或蒸汽状态的化学物质在气相或气固界面上经化学反应形成固态薄膜的技术,常用的化学气相沉积技术有常压化学气相沉积(AP)、低压化学气相沉积(LPCVD)、等离子化学沉积(PECVD)。其中,常压化学沉积由于其台阶覆盖率差,存在粒子污染的缺点很少被使用,而LPCVD和PECVD由于其批量生产能力强、台阶覆盖率高被广泛的使用。化学气相沉积的原理如图1所示,首先,在气体中发生化学反应,然后反应生成的中间产物到达衬底表面并在表面快速迁移和重新分布,最后,中间产物吸收衬底能量进一步反应生成固态产物聚集形成薄膜,而其他副产物从衬底表面解吸附被主流气体带走。在该过程中,APCVD可以理解为完全依靠自然反应进行淀积,LPCVD可以理解为通过压力增加反应中间产物在衬底表面聚集,PECVD可以理解为通过等离子加速化学反应速度从而增加沉积速率。
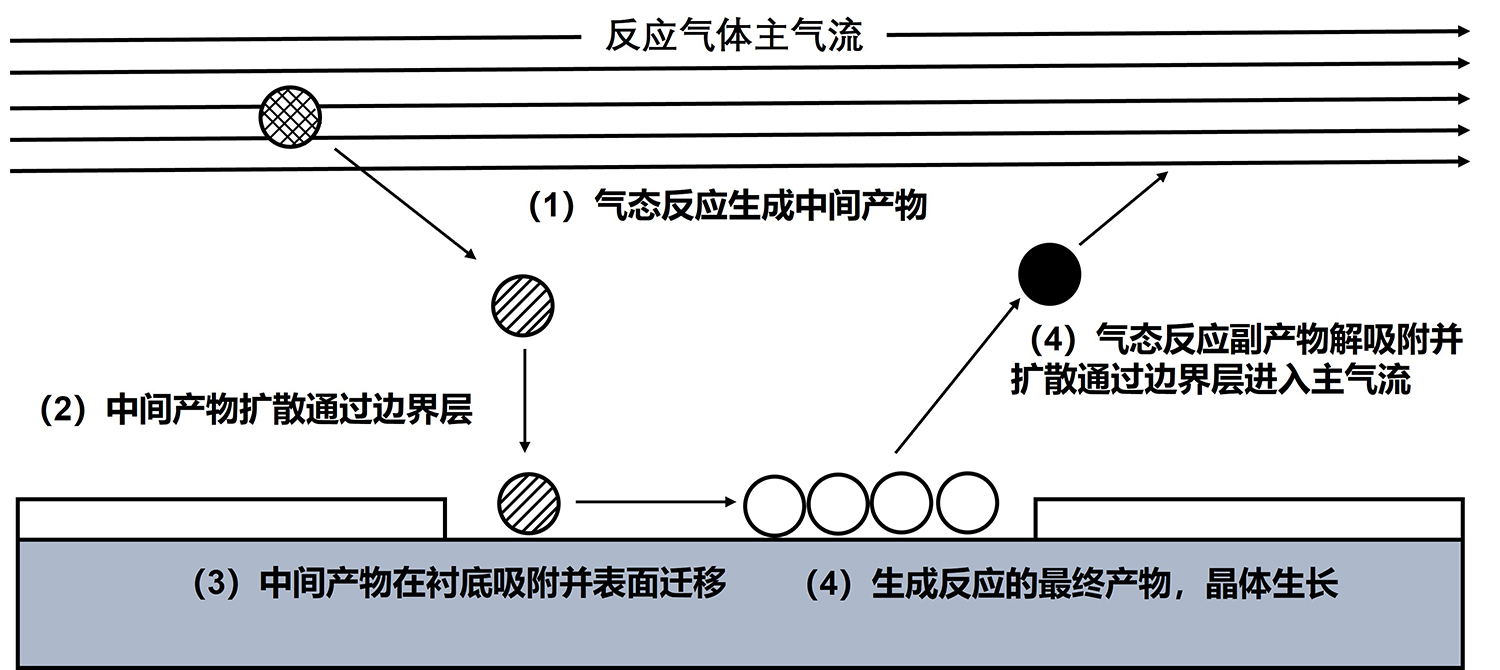
图1.化学气相沉积基本原理过程
化学气相沉积在MEMS中应用广泛,可以用于制备多晶硅、氮化硅、氧化硅、金刚石等等,以图2为例,可以采用化学气相沉积不同的材料层,然后根据不同材料的化学特性进行腐蚀,从而制备出悬臂的可动结构。

真空镀膜是将固体材料至于真空室内,在真空条件下,使用一定的能量形态迫使固体材料的原子或分子从表面脱离,当衬底放在真空容器中时,弥补原子或者分子就会吸附在衬底上形成一层薄膜。目前,真空镀膜有两种方法,即溅射和蒸发,原理如图3所示,溅射镀膜的原理与溅射刻蚀原理类似,溅射镀膜提高了氩离子能量并轰击靶材,是靶材原子迁移出靶材表面然后在衬底表面形成薄膜;蒸发镀膜分为电阻热蒸发和电子束蒸发两种,实际上为加热方式不同,电阻热蒸发是在高真空条件下利用大电流加热固定在支架上的镀膜材料使其蒸发;电子束蒸发是由热丝发射的电子经过聚焦、加速后形成的电子束轰击放在坩埚中的金属使其蒸发再淀积在衬底上形成金属层。
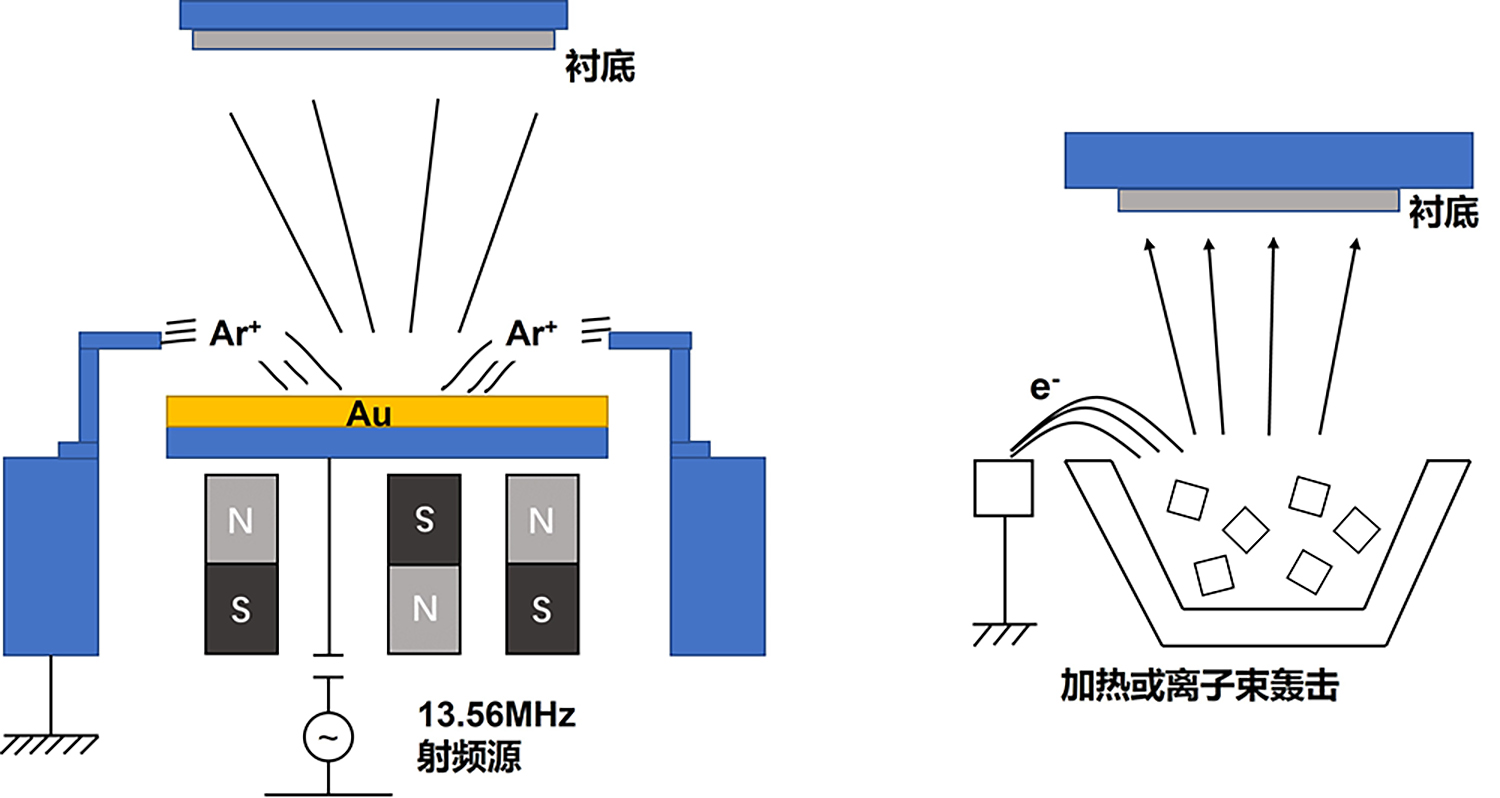
图3.溅射金属镀膜(左)和蒸发金属镀膜(右)设备原理
SOI衬底结构中存在着三层结构,器件层、预埋氧化层和衬底层(图4),预埋的氧化层可以用来作为敏感元件和衬底之间的电隔离,替代传统的扩散硅压力传感器中使用的pn结电隔离,高温下不会出现漏电现象,并能够在250~300℃的高温条件下长期工作,而传统的使用温度则一般不能超过150℃。目前,SOI衬底已经在微扫描镜、微陀螺仪和微传感器等MEMS器件上获得了广发应用。

图4.SOI衬底的三层结构
SOI的制备方法主要有三种,分别是键合减薄法、注氧隔离法和智能剥离法。注氧和智能剥离法往往需要采用离子注入将氧离子和氢离子注入到硅片中,不适合大规模生产,这里不做详细介绍,主要介绍键合减薄法,键合减薄法首先将一张单晶硅片热氧化在表面生成一层氧化硅,然后把氧化后的硅片和一片单晶硅片键合,最后将单晶硅片使用CMP设备减薄并抛光,得到SOI硅片,其流程如图5所示。

图5.键合减薄法制备SOI流程
在上节文章中只介绍了二氧化硅薄膜的制备方法,而在MEMS中尝尝需要制备很多不同材料层,针对于此,本文章主要介绍制备其他材料薄膜常用的化学气相沉积技术、金属薄膜的制备方法、以及SOI硅片制备工艺。

 服务热线:
服务热线:
