读懂MEMS光刻(一):光刻机及其系统参数
在介绍光刻机之前,我们首先要了解一个非常重要的公式,即Rayleigh公式:

其中:分辨率代表光刻的最小线宽,有时分辨率也被标注成关键尺寸CD,λ是光的波长,NA一般代表光刻机的数值孔径,接触式光刻机NA 约为0.5-0.8,投影式约为0.6-1.2; K表征光刻工艺难易程度的正比系数,通常取值1.22。
近年来,研究人员围绕Rayleigh公式从几个方面针对光刻的分辨率进行提升:
1、光
众所周知,在光的世界里面,除了我们肉眼可见的紫、蓝、绿、黄、红等光外,仍存在着肉眼不可见的X-射线、以及红外光。其中,我们肉眼可见的380nm-780nm光以及波长更长的红外光显然是不适合提升光刻的分辨率的,故光刻用的波长常采用紫外光。
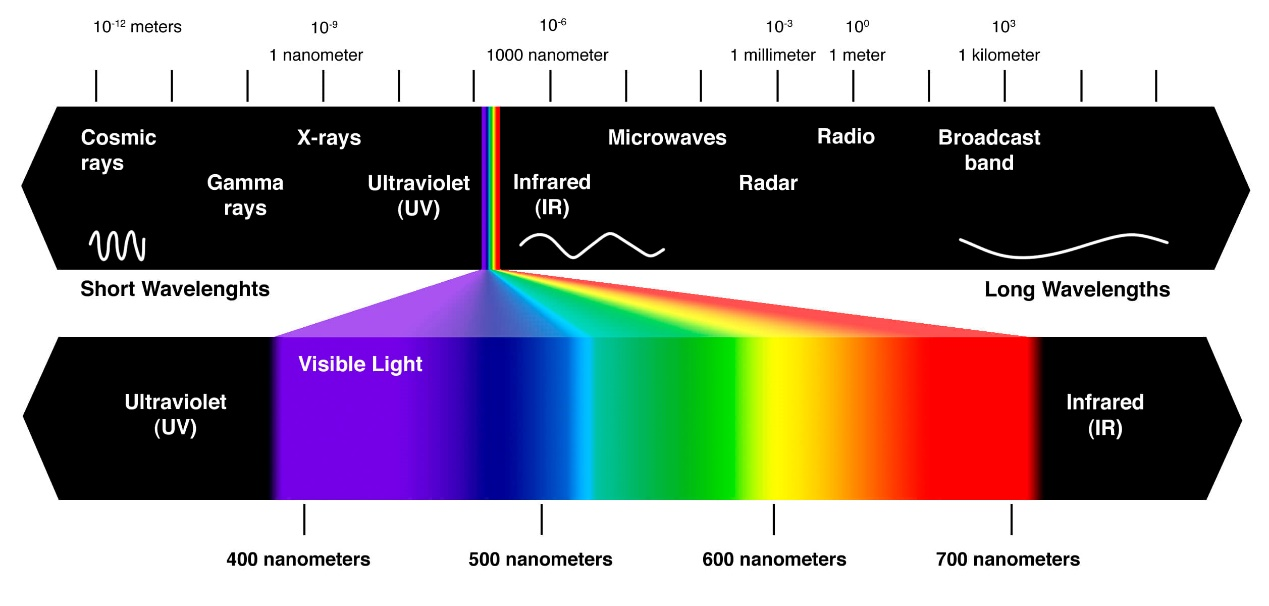
高压汞灯因其亮度和拥有许多尖锐谱线而被选作可靠的光源,然而汞灯的辐射光中具有365nm的i线,405nm的h线和436nm的g线,不同的曝光波长可以通过使用不同波长的滤光片来选择。然而,汞灯的248nm的DUV的光源强度非常低,就只能增加曝光时间,会大大降低生产效率。因此,进入纳米时代,光源基本用的都是248nm的KrF准分子激光,或者193nm的ArF激光。

2、数值孔径
除了光刻机的曝光波长外,另一条路径即围绕增加光刻机的数值孔径:

其中:
NA代表光学系统的数值孔径
n是光学介质的折射率(refractive index),
θ是入射光线与光学轴之间的最大半角。
简单理解,折射率即样品与镜头之间介质的折射率,如果是空气或者真空,它的折射率接近1.0或者1.0,目前最高的浸润式光刻机采用折射率1.46的去离子水。而θ角受到镜头尺寸以及镜头与硅片之间距离的影响,镜头尺寸越大,距离越短,将会增大θ角。当然,镜头尺寸越大,制造难度也就越大,结构也就越复杂。
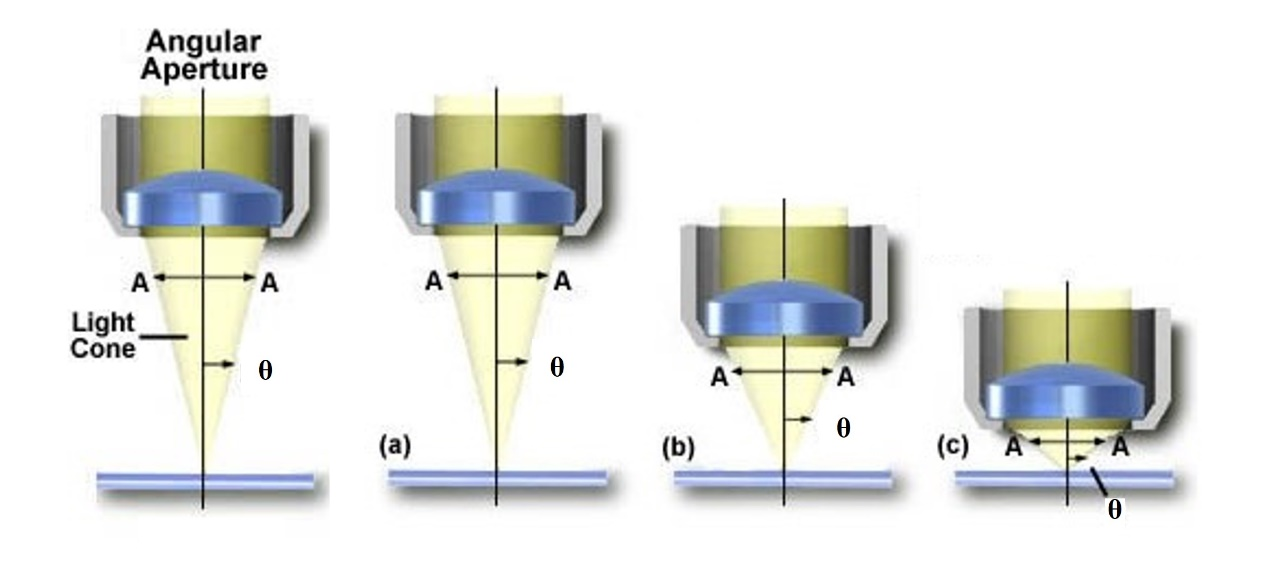
下图给出了接触式、步进式、EUV光刻机的实物图,可以看到,光刻机随着分辨率的提升,光刻机的尺寸增加了不止一倍,相应的光刻机和光刻工艺的成本也明显增大。然而,针对MEMS领域中,大部分光刻工艺的尺寸都围绕在500nm到几百微米,所以往往不需要深紫外、极紫外的光源以及复杂光学系统下的高数值孔径,考虑到工艺成本,MEMS常用的光刻机为接触式光刻机,常用于曝光2μm以上的图形,步进式光刻机,常用于曝光350nm以上的图形。


 服务热线:
服务热线:
