MEMS之光刻技术
近年来,我国集成电路行业迅速发展,在发展过程中受到了很多技术和知识版权的阻碍,从限制华为的芯片代工导致其手机市场占有率大幅下降、停止高性能的GPU供应以及限制各种仿真软件的版权并停止对中国授权等等,其中我们最常听说的就是光刻机及光刻工艺,下面将为大家简单介绍光刻过程,以便于理解。
在介绍光刻之间,我们首先要了解以下几个材料:
1)衬底:即组成成分为单晶硅的硅片。
2)掩膜板:以透明的石英或者玻璃为主体,表面溅射或蒸镀一层不透光的铬金属,再根据设计的版图将铬腐蚀形成对应的透光区,其结构如图1所示。

图1.掩膜板顶视图(左)和掩膜版立体图(右)
3)光刻胶:又称光致抗蚀剂,是指通过紫外光、电子束、离子束、X射线等的照射或辐射,其溶解度发生变化的耐蚀剂刻薄膜材料。分为正胶和负胶,正胶受到光照的部分化学性质改变,能够被碱性显影液溶解,即受到光照部分形成孔洞;负胶与正胶相反,受到照射的部分不容易被显影液溶解,即受到光照的部分被留下。
4)显影:在正性光刻胶的曝光区和负性光刻胶的非曝光区的光刻胶在显影液中溶解,在光刻胶上形成三维图形的一种光刻技术。其中,显影液是溶解由曝光造成的光刻胶的可溶解区域的一种化学溶剂。
了解了光刻材料后,可以根据下述图例进行深入理解:
1、采用光刻胶的正胶,其光刻过程如图2所示:首先,在硅片上旋涂光刻胶(正胶)并对其进行软烘提高附着力,然后,进行光刻机、掩膜版以及衬底的对准以便能够将掩膜版上的图形精确地转移到衬底上,再经过曝光后,受到紫外光照射的部分易被显影液溶解去除,最后,经过显影后留下未被照射的部分。
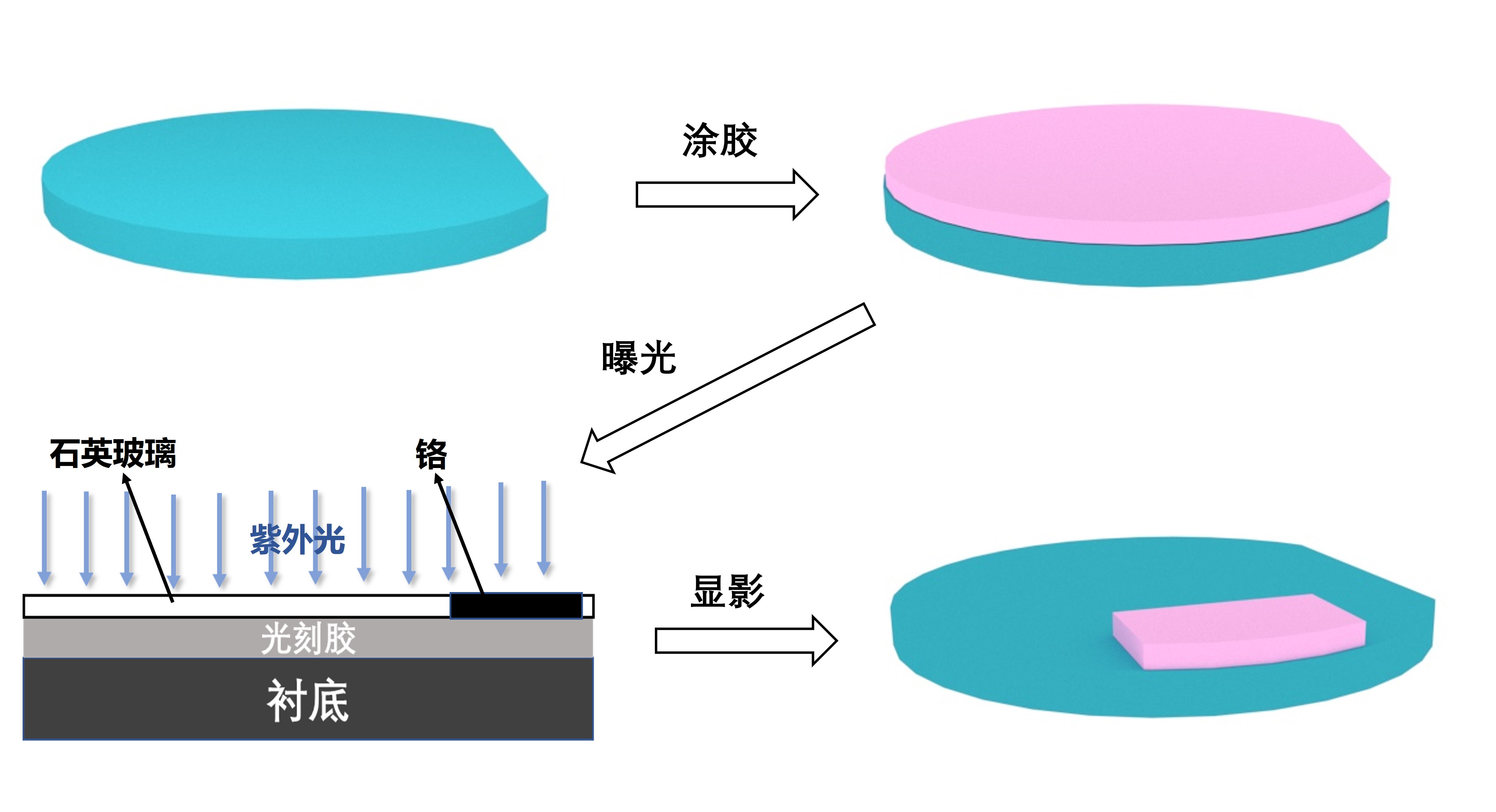
图2. 采用正胶光刻基本流程
2、采用光刻胶的负胶,其光刻过程如图3所示:负胶的光刻流程相同,只不过由于负胶的特性,其受到光照的位置不易被显影液所溶解,故在经过曝光、显影后留下部分是受到光照的部分。
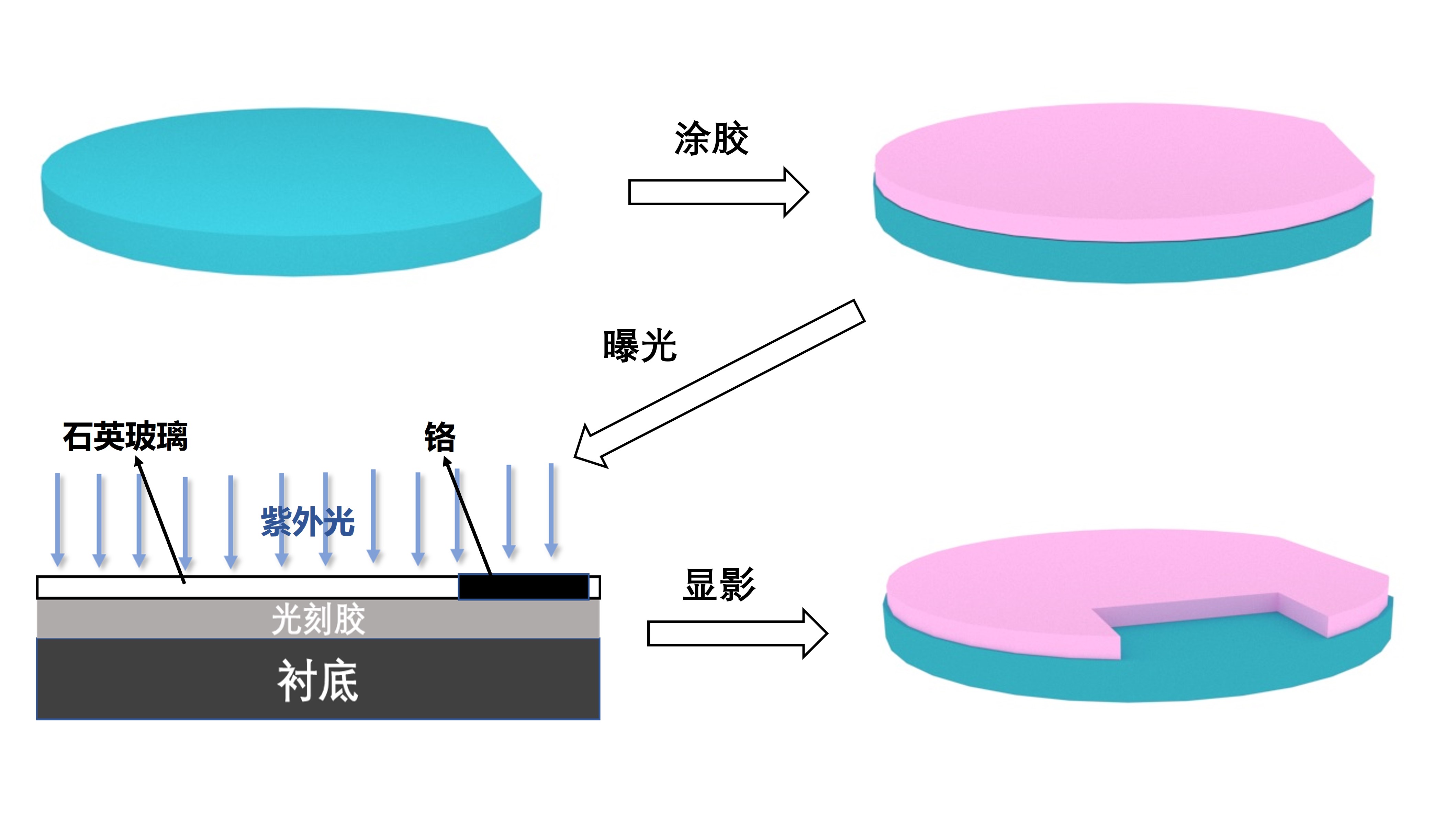
图3. 采用负胶光刻基本流程
以上是对光刻过程简单的阐述,以方便理解。实际的光刻过程要复杂的多,例如,掩膜版与光刻机、衬底的距离、光刻胶的相关参数、显影液的溶解去除效果等等,都会对最终制备的产品产生关键的影响。芯云纳米一直致力于对制备工艺的控制、优化、创新,以制备优良的器件,满足客户需要。

 服务热线:
服务热线:
