MEMS之干法刻蚀
由于湿法腐蚀过程中需要使用大量的化学药品,会对环境产生污染,并且其只适合较粗的线宽(大于3μm),为了避免湿法刻蚀的缺点并提高加工精度,科学家们开发了干法腐蚀。干法刻蚀是利用等离子体进行刻蚀的技术,什么是等离子?我们生活的环境中物质的状态有我们常见的气态、液态、固态,而等离子体是物质的第四种状态(图1),自然界中等离子体的产生需要上万摄氏度的高温,而人工等离子体主要通过提供能量使原子钟的外层电子克服原子核束缚的能量,从而产生的自由电子、离子、及中性粒子称为等离子体。
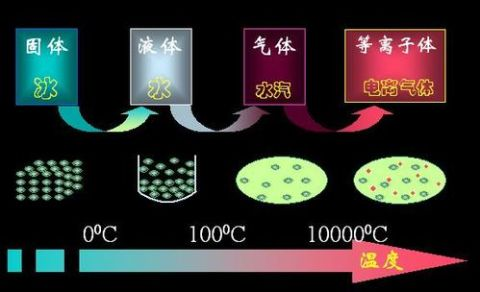
图1.自然界物质的四种状态
干法刻蚀可以划分为物理刻蚀、化学刻蚀、物理化学刻蚀三种。
1)物理刻蚀又称为溅射刻蚀,纯粹依靠带电离子的轰击作用进行刻蚀,刻蚀的方向性很强,但无选择性。其溅射刻蚀结构图如图2所示,在实际的制备过程中,溅射刻蚀往往用于离子清洗轰击清洗衬底表面,以去除表面及赃物,为后续薄膜淀积提供干净的表面。
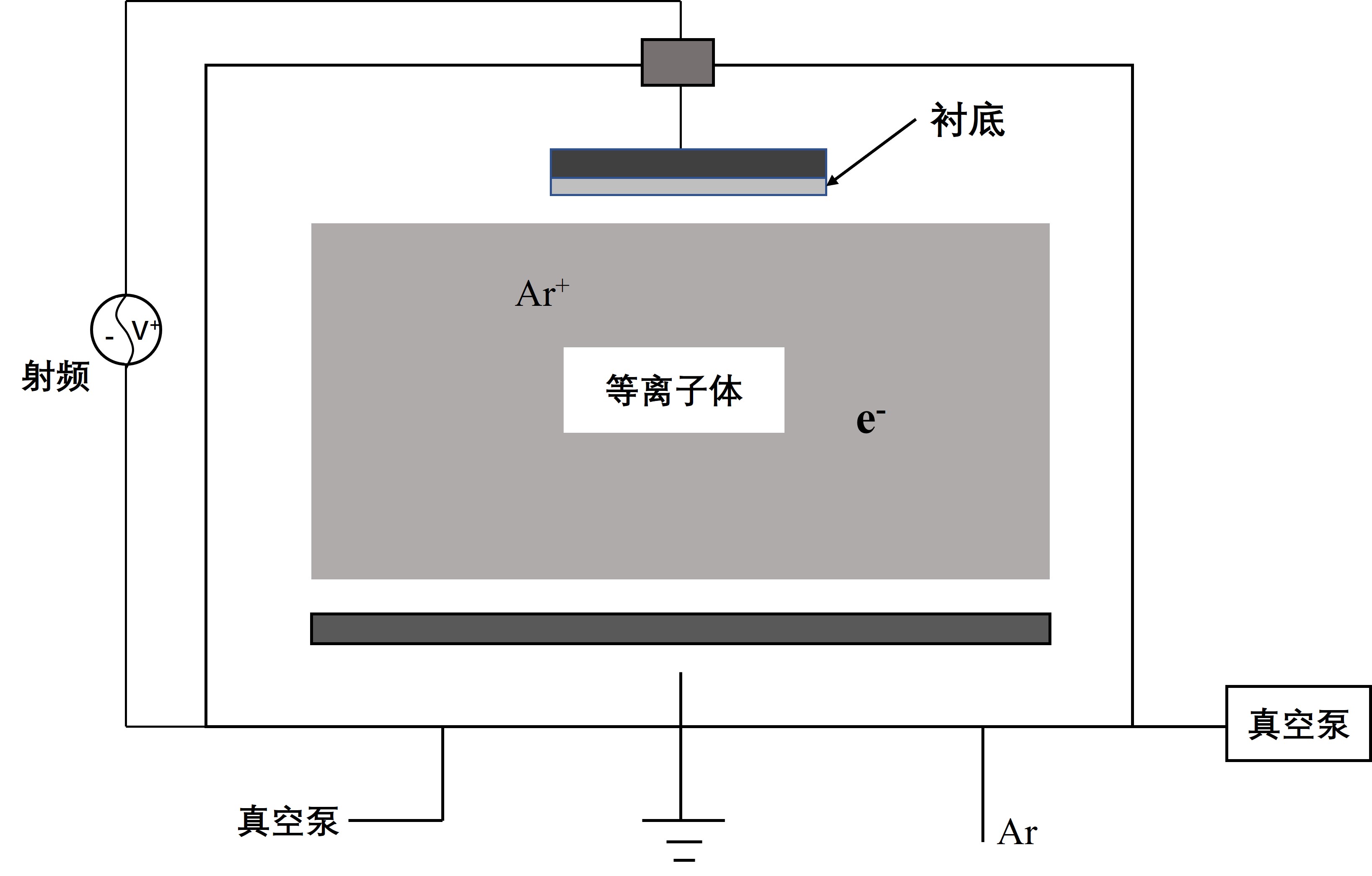
图2. 溅射刻蚀结构原理图
2)化学刻蚀又称等离子刻蚀,是纯粹利用等离子体中的活性原子团(活性自由基、不带电、不受电场的加速作用)与被刻蚀对象发生化学反应,生成挥发的产物被真空系统抽离去除,这种刻蚀没有离子损伤问题,刻蚀速率高,选择性好,但是化学反应的刻蚀是各向同性的,它的应用越来越受到限制,一般用于特征形貌没有要求的去胶工艺,其中,使用氧等离子进行灰化工艺如图3所示。
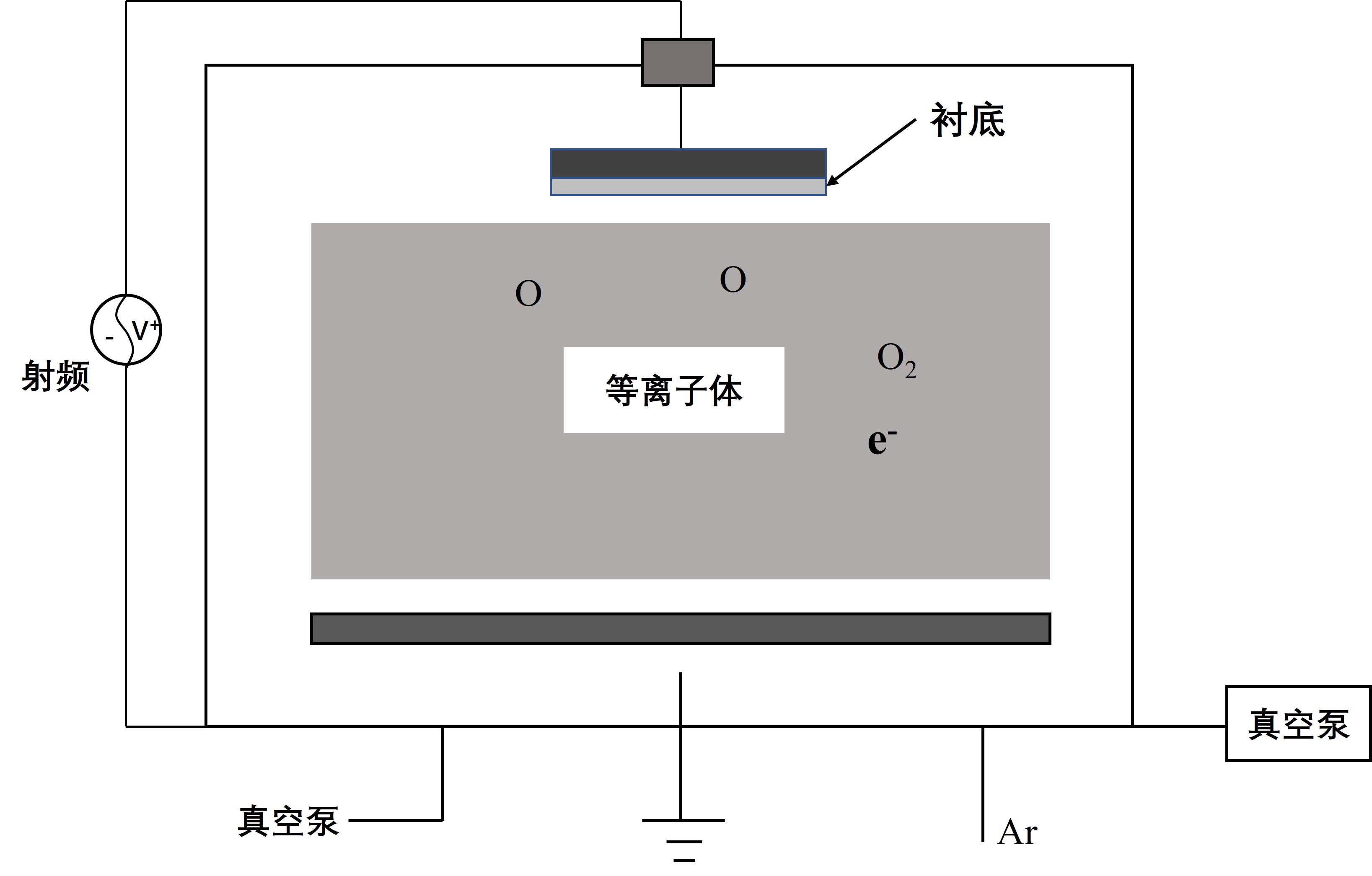
图3.氧等离子灰化工艺
3)物理化学刻蚀又称反应离子刻蚀,是同时用化学反应和物理轰击进行刻蚀,具备以上两种刻蚀的优点,具有良好的形貌控制能力、较高的选择比、可以接受的刻蚀率,可以通过选择合适的气体组分获得理想的刻蚀选择性和速度,应用非常广泛,以CF4气体刻蚀硅的结构原理图如图4所示,首先,CF4气体在等离子体状态下分裂为具有化学活性的活性自由基F和具有物理轰击作用的离子CF4;然后,F自由基扩散并吸附到硅片表面,F自由基到达被腐蚀表面后,四处移动并重新分布,然后,F自由基与硅材料发生反应并生成挥发性产物SiF4,最后,产物离开硅片表面被真空系统抽离反应室,以尾气形式排出

图4.CF4等离子体刻蚀硅的原理
反应离子刻蚀常用的特气及其刻蚀对象如下表所示
类别 | 被腐蚀材料 | 刻蚀对象 | 刻蚀产物 |
氯基 | Cl2和BCl3 | 铝 | AlCl3 |
氟基 | SF6,CF4,CHF3 | 二氧化硅、氮化硅、硅 | SiF4、N2、H2O |
氧基 | O2、O3、CO2、H2O | 光刻胶及其他有机物 | CO、H2O |
反应离子刻蚀是介于各向异性和各向同性之间的刻蚀方法,仍然存在侧向掏蚀,在刻蚀深度比较大时,无法得到陡直的侧壁和精确控制的线宽,此时需要采用深度反应离子刻蚀,即通过调整射频源和平板源对反应离子的射频功率和等离子密度进行高纵横比刻蚀。其原理如图5所示,通过先通入SF6气体刻蚀,然后通入C4F8气体进行淀积形成一层聚合物薄膜,最后通过循环以上步骤以制备深宽比较大的结构。
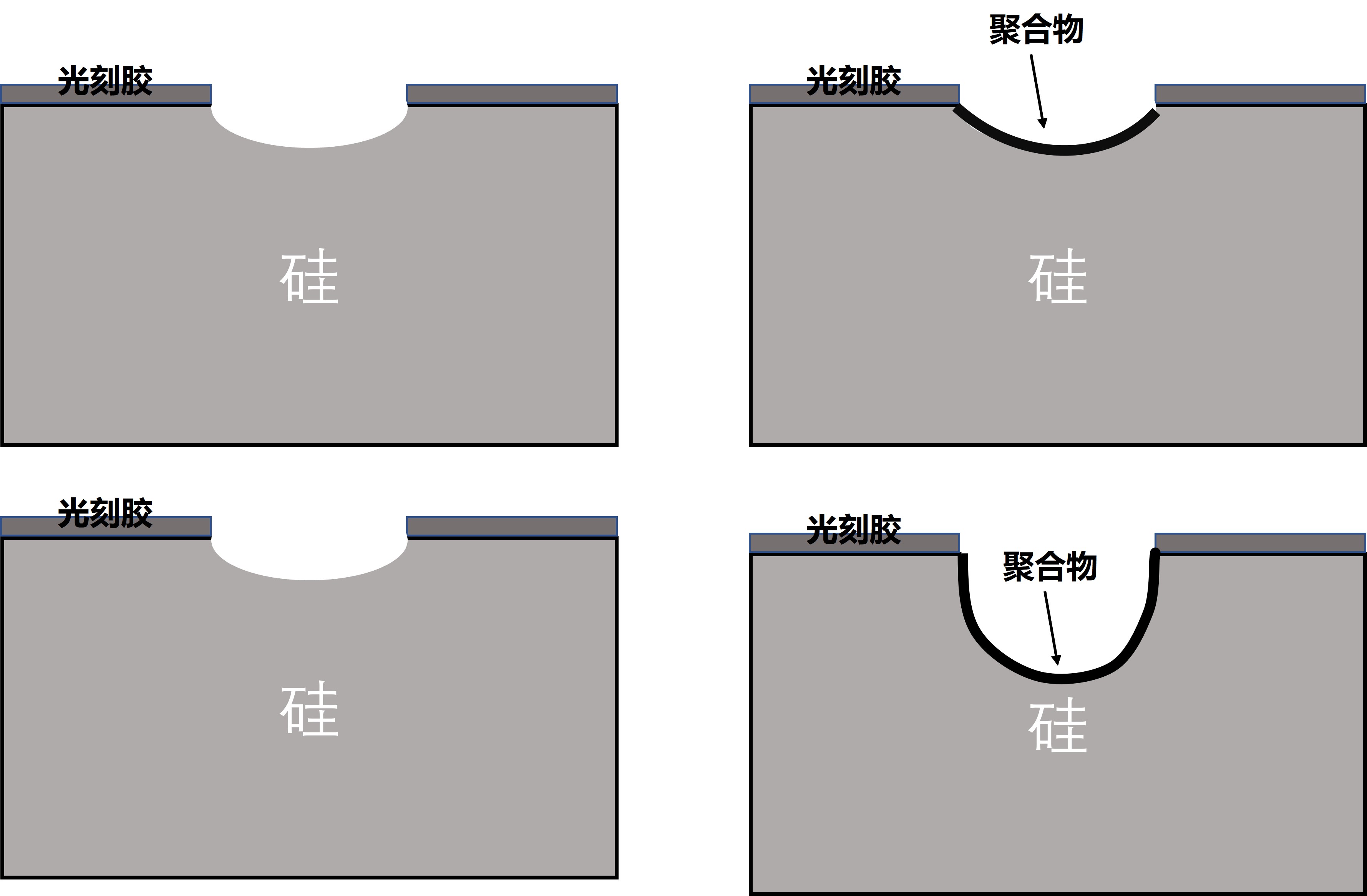
图5. 深度反应离子工艺步骤
在实际MEMS的制备过程中,往往需要通过器件的具体要求选择合适的加工工艺,湿法腐蚀和干法腐蚀各具优点和缺点,如何选择需要工艺人员综合考虑并进行验证。

 服务热线:
服务热线:
